後工程の内容
半導体を製造するうえで前工程と後工程があります。(前工程は割愛いたします)
半導体の製造は設計工程と前工程、後工程に分けられており、半導体は設計工程を経て、前工程でシリコンウェハ上に大規模集積回路(LSI)を作ります。
その後、後工程で集積回路をそれぞれのチップに切り分けます。
後工程では半導体をウェハから切り出し、製品の形にしていきます。前工程では、シリコンインゴットから作られたウェハに、数百個の半導体が並んだ大規模集積回路が作られています。そこで、後工程ではこの集積回路を一つずつ切り出し、製品として使用できるよう、さまざまな加工を施します。
後工程で行われる加工は、次のとおりです。

ダイシング
ウェハをダイヤモンドブレードで切断し、チップごとに分離します。ダイシング工程ではウェハをダイシング用テープに貼り付け、回転する円形状のダイヤモンドブレードで超純水をかけながら、並んでいる半導体の間を切り離します。
ダイシングでは、ダイヤモンドブレードを使う方法以外にも、レーザーでカットするレーザー方式や、ウェハにけがき線(薄い引っかき傷状の線)を入れてクラックを起こしてカットするスクライブ方式、プラズマでエッチングして切り離すプラズマダイシング方式などがあります。
ダイシング用テープを使用している場合、ウェハを固定しているテープは切断されないのがポイントです。切断後、ダイシングテープを引き延ばすことでチップの間にクリアランスを作り、取り外しなどの作業をしやすくします。
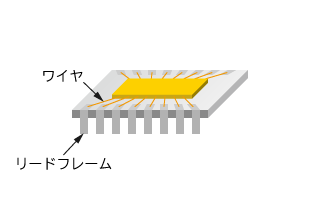
ワイヤボンティング
リードフレームにチップを固定(ダイボンディング)します。リードフレームとは薄い金属で作られたチップの支持体であり、半導体を基板に実装する際の端子ともなる部品です。
リードフレームには熱の拡散機能を備えているものもあるほか、パワー半導体などの製造では、リードフレームではなくヒートシンクにマウントされるケースもあります。ダイボンディングでは銀ペーストなどの接着剤が使用されます。
ダイボンディングの後は、チップとリードフレームを金で作られた細いワイヤで接続するワイヤボンティング工程です。これによりチップがリードフレームを介して配線できるようになります。
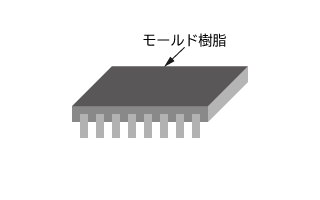
モールディング
チップは非常に繊細な製品のため、傷や衝撃、ホコリや磁気などにより影響を受けてしまいます。そのため外部の影響から保護するためにチップを、エポキシ樹脂で包み込みます。これをモールディング(モールド工程)またはパッケージング(封止成型)といいます。
しかし近年では、製品の小型化に伴い、より小さな半導体が求められています。これに対応するのがベアチップというパッケージ化されていない半導体です。ベアチップは基板に立体的に積層できるのがメリットですが、チップの歩留まりが悪いというデメリットもあります。
ダイシング、ワイヤボンティング、モールディングを経たチップは、検査工程を経て出荷されます。
株式会社アイエスで製造しているダイシング用テープフレームは上記のダイシングの際に ダイシングソーにウエハ(ウェーハ)を固定するための治具(ジグ)として、
またはウエハ(ウェーハ)の搬送用として使用されています。